J. A. Woollam M2000 T-Solar RCE Ellipsometer
Ansprechpartner:
|
Nutzung |
|---|
|
|
Spezifikationen |
|---|
|


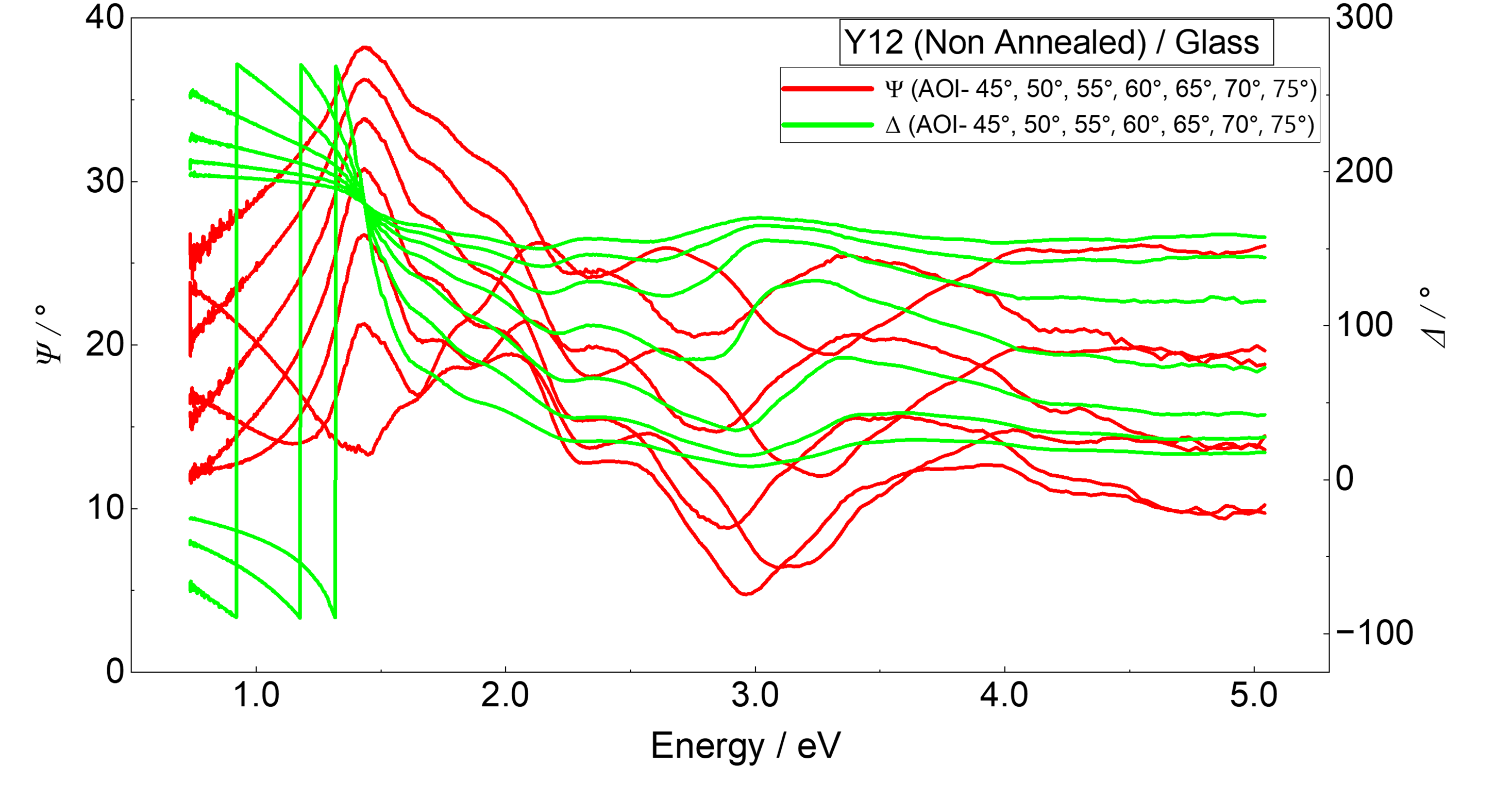

Ansprechpartner:
|
Nutzung |
|---|
|
|
Spezifikationen |
|---|
|


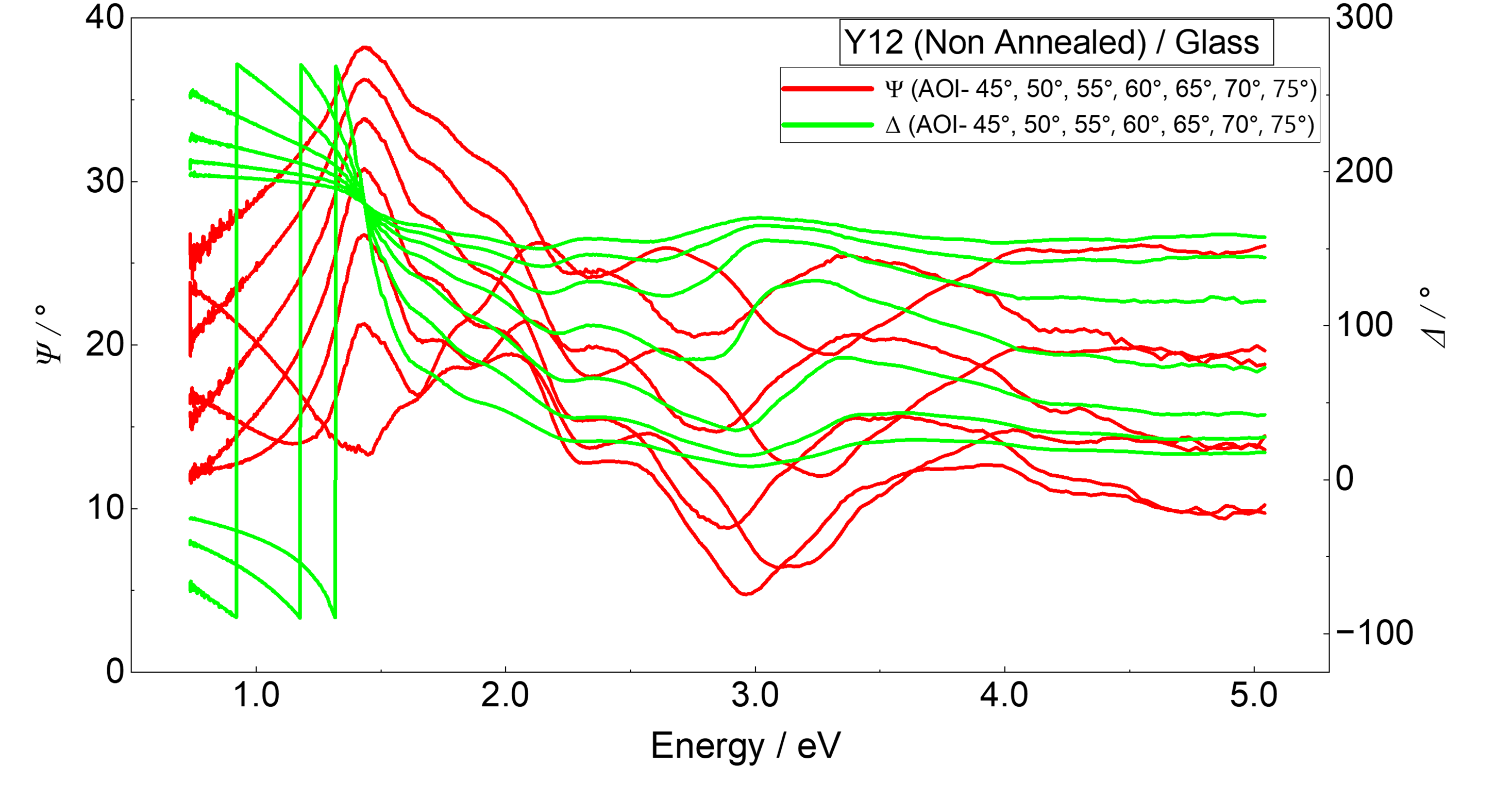

Zentrum für den wissenschaftlichen Nachwuchs der TU Chemnitz veröffentlicht neues Programm für Promotionsinteressierte, Promovierende, Promovierte und Habilitierende …

Aktionstag der Politischen Bildung an der TU Chemnitz brachte 80 Lehrkräfte aus Sachsen mit Lehramtsstudierenden der TU Chemnitz zusammen …

Zentrum für kriminologische Forschung Sachsen e. V. beteiligte sich an internationaler Replikationsstudie im Bereich der Sozial- und Verhaltenswissenschaften …

300 Forscherinnen und Forscher besuchten Ende März 2026 die 35. Jahrestagung der Gesellschaft für Didaktik des Sachunterrichts an der TU Chemnitz …
Elektrokatalyse ermöglicht effiziente Umwandlung und Speicherung von …
Auslandssemester und -praktikum weltweit! Komm vorbei und erfahre …
Vom 8. bis 10. Mai 2026 findet das 13. Alumni-Treffen der TU Chemnitz statt. Alle Ehemaligen sind …
Vier Veranstaltungen zum ENTDECKEN, MITMACHEN und STAUNEN: Die Gäste erleben den Tag der offenen …
Tanz und gute Laune bis Mitternacht: Verschiedene Musik- und kulinarische Angebote sorgen im …
Kannst du dir vorstellen, dass Autos in Zukunft ganz allein fahren? In …