Bauteil-Zuverlässigkeit
Die Funktionalität eines leistungselektronischen Bauelements ist durch viele Faktoren begrenzt. Im Rahmen von Zuverlässigkeitsuntersuchungen werden Bauteile bei verschiedenen Umgebungsbedingungen und elektrischer Konditionierung im Rahmen standardisierter Tests, oder darüber hinaus bis zum Ausfall, zyklisch beansprucht. Um eine hinreichende Vergleichbarkeit mit anderen Bauteilen oder Teststrategien zu erzielen sind Normierungen und umfangreiche statistische Evaluationen unumgänglich.
HTGB - High Temperature Gate Bias Test
|
Das Gate-Oxid von spannungsgesteuerten Leistungshalbleitern wie MOSFETs oder IGBTs weist eine Dicke im Bereich von 100nm auf und kann bei Siliziumkarbid-MOSFETs (SiC-MOSFETs)
noch deutlich geringer sein. |
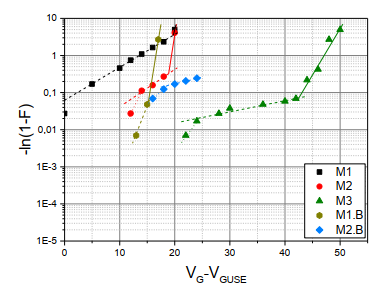
|
HTRB - High Temperature Reverse Bias Test
Im HTRB Test (High Temperature Reverse Bias) werden Leistungshalbleiter dauerhaft einer Gleichspannung ausgesetzt, um die Langzeitstabilität der Sperrströme zu untersuchen. Die hohe Sperrspannung, in der Regel mindestens 80% der spezifizierten Sperrspannung, simuliert zusammen mit einer hohen Sperrschichttemperatur innerhalb von 1000h einen Lebenszyklus der Prüflinge im Feld. Dabei lassen sich Schwachstellen in der Passivierungsschicht bzw. in der Randstruktur sowie an den Chipkanten aufdecken. Bewegliche Ionen, resultierend aus einer Kontamination während des Herstellungsprozesses, können zu lokalen Feldüberhöhungen führen und sich zu Oberflächenladungen anreichern. Somit können in Bereichen niedrig dotierter Zonen Inversionskanäle entstehen und zum Anstieg des Sperrstroms führen, die pn-Übergänge kurzschließen können. Um dieses Verhalten zu untersuchen ist eine dauerhafte Messung des Sperrstroms während des Tests erforderlich.
H³TRB - High Humidity High Temperature Reverse Bias Test
In Anwendungsgebieten wie Photovoltaik oder On- und Offshore-Windparks sind Leistungshalbleiter rauen Umwelteinflüssen ausgesetzt. Dabei kann besonders hohe Feuchtigkeit den Leistungsschaltern stark zusetzen, indem diese durch die Silikonweichvergussmasse in Module eindringt und die Halbleiter durch Korrosion schädigt. Das verwendete Silikon weist häufig eine hohe Permeabilität auf, die zwar Feuchtigkeit schnell aufnimmt aber andererseits diese auch schnell wieder abgibt. Im H³TRB wird eine gleichzeitige Belastung durch hohe Luftfeuchtigkeit und hohe Temperatur unter anliegender Sperrspannung simuliert, um den Einfluss auf die Sperrströme zu untersuchen. Dabei erfolgt der Test innerhalb einer Klimakammer unter einer Temperatur von 85°C bei einer relativen Luftfeuchtigkeit von RH=85%. Die Sperrspannung ist in den meisten Normen auf maximal 80V begrenzt. Aufgrund des zunehmenden technologischen Fortschritts bei Leistungshalbleitern mit hoher Bandlücke wie Siliziumkarbid (SiC) und Galliumnitrid (GaN) rückte eine Modifikation der Teststrategie in den Vordergrund. Bei HV-H³TRB Tests kann eine Sperrspannung von bis zu 80% der spezifizierten Sperrspannung an die Prüflinge angelegt werden, um damit den Alterungsprozess zusätzlich zu beschleunigen.
