Überlastuntersuchungen
Das Forschungsfeld der Überlastuntersuchungen beschäftigt sich mit der Simulation und Messung von kritschen Betriebszuständen von Leistungshalbleitern.
Im Datenblatt eines Leistungshalbleiters sind nominelle Betriebszustände vermerkt, unter denen der Betrieb des Halbleiters vom Hersteller gewährleistet wird, ohne das ein Ausfall des Bauelements erwarten werden muss. Diese Betriebszustände sind durch eindeutige Angaben von maximalen Spannungen an den Kontakten, Temperaturen, Arbeitspunkten etc. beschrieben. Abnormale Zustände, welche sich zumeist im Fehlerfall einer leistungselektronischen Schaltung für den Halbleiter ergeben, sind selbst für moderne Halbleiter sehr kritisch. Aufgrund der Halbleiterphysik, sowie der Aufbau- und Verbindungstechnik, ergeben sich für den Halbleiter konkrete Grenzen der maximalen Temperatur, maximalen Spannung an den Kontakten, Stromstärke, Flankensteilheit etc. welche den normalen Arbeitsbereich einschränken. Besonders im Hinblick auf die Verwendung neuartiger Halbleitermaterialien wie SiC oder GaN, ergibt sich oft die Fragestellung, ob besagte Materialien den hohen Standard von Si-Bauteilen einhalten oder gar übertreffen können?
Ziel der Untersuchungen ist es durch gezielte Überlastung des Bauelements Schwachstellen im Halbleiter und der Aufbau- und Verbindungstechnik zu finden. Die Ergebnisse werden wie folgt genutzt:
|

|
Kurzschluss
Im Kurzschlussversuch wird das Bauelement in einem Zeitbereich von Mikrosekunden durch hohe Spannungen und Ströme beansprucht. Moderne Leistungshalbleiter auf Siliziumbasis gewährleisten eine Robustheit bei erhöhter Temperatur und spezifizierter Sperrspannung von etwa 10μs. Im Zuge der Messungen werden verschiedene Kurzschlussarten, bei verschiedenen Gatespannungen, unterschiedlichen Sperrspannungen und Treiberbeschaltungen untersucht.
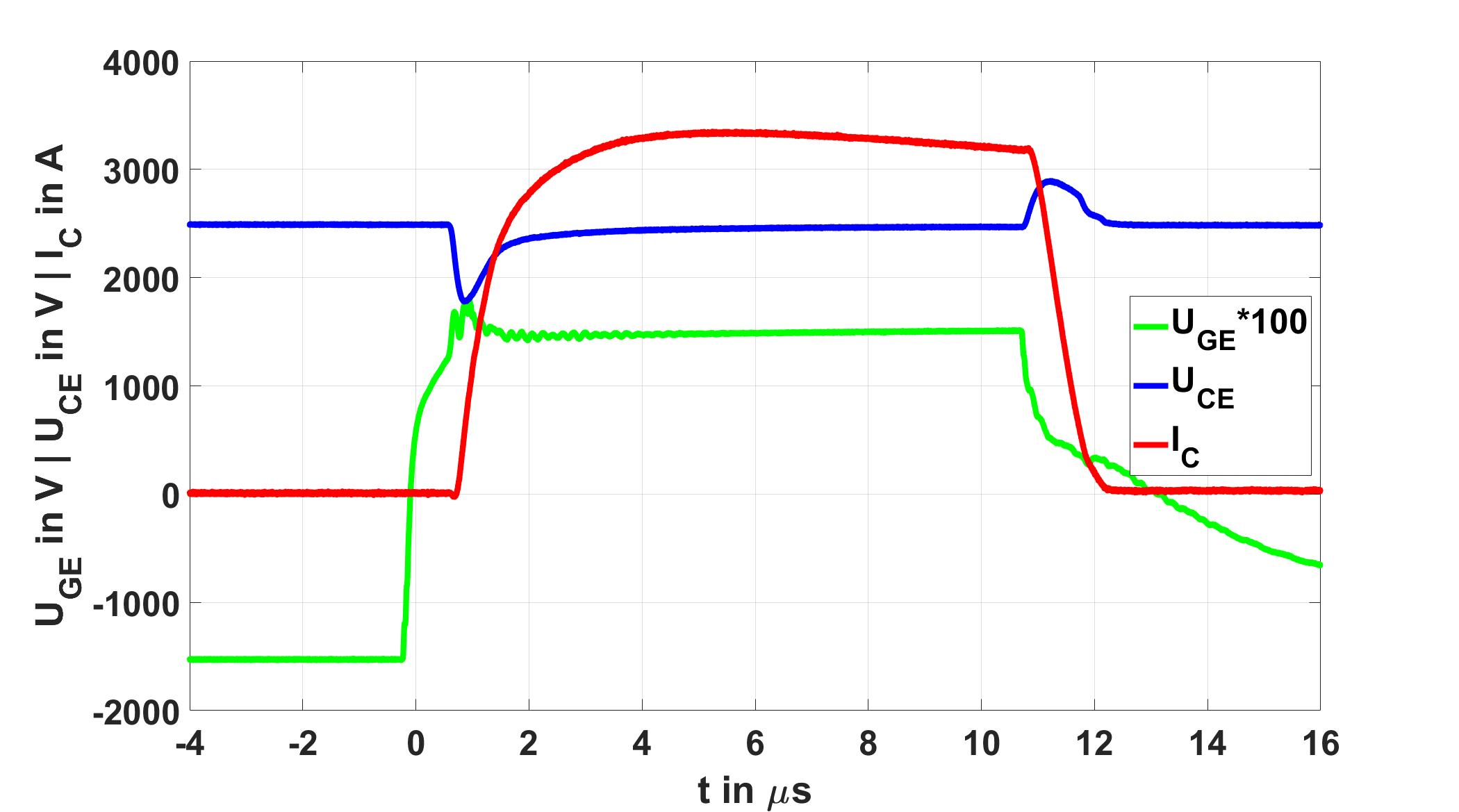
|

|
Stoßstrom
Stoßstromuntersuchungen werden zumeist bei Dioden angewendet. In Abhängigkeit des Anwendungsfalls können jedoch auch schaltbare Bauelemente wie der IGBT von einer Stoßstromfestigkeit profitieren. Bauelemente werden im Laufe der Untersuchung bei angenommener Netzfrequenz durch einen halbsinusförmigen Strom belastet. Im Unterschied zum Kurzschluss ergibt sich also eine deutlich größere Belastungsdauer und somit unterschiedliche Fehlerbilder bzw. Ausfallmechanismen. Die Stromstärke wird schrittweise erhöht, bis das Bauteil seine Sperrfähigkeit verliert oder während des Pulses thermisch zerstört wird.
|
|
Avalanche
Die Sperrfähigkeit von Leistungshalbleitern wird vom Lawinendurchbruch begrenzt, welcher oberhalb der spezifizierten Sperrspannung auftritt. Im Datenblatt finden sich lediglich Informationen zur Avalanche-Robustheit, wenn das Bauteil einem gewissen Strom in diesem Arbeitsbereich ausgesetzt werden kann ohne zerstört zu werden. Üblicherweise wird der Betrieb eines Bauelements im Avalanche-Bereich beim sogenannten "unclamped inductive switching" (UIS) untersucht. Im Gegensatz zum Doppelpulsversuch, kommt es zu einer drastischen Spannungsüberhöhung am Prüfling, da sich der Strom nicht freilaufen kann und hart abkommutiert. Eine sorgfältige Auslegung von Teststandparametern ist notwendig um das Bauteil schrittweise in den Avalanche-Bereich zu bringen und entsprechende Grenzen zu untersuchen.
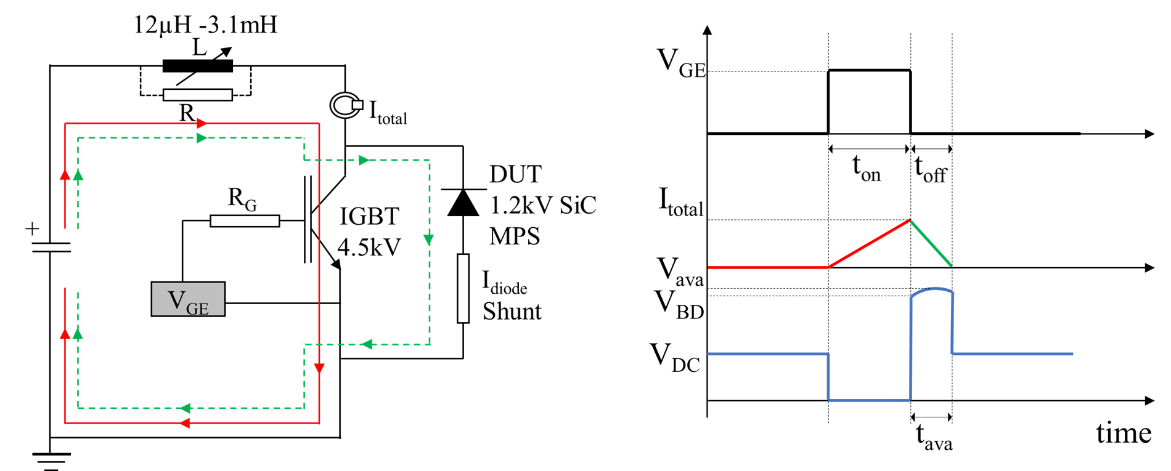
|

|
