Röntgenphotoelektronenspektrometer (XPS)
Ultrahochvakuumkammer mit
- Photoelektronenanalysator (Specs Phoibos 150 mit 9 Channeltrons)
- Monochromatisierte Röntgenquelle (Specs Focus 500) für Al Kα und Ag Lα
- Elektronenkanone zur Ladungskompensation
- Probenmanipulator mit Heizung bis 1200 °C
- Ar-Ionenquelle (Sputterkanone)
- LEED-Optik
- Ports für Verdampfer, Quarzwaage, Massenspektrometer, etc.
Typische Anwendungen:
- Analyse chemischer Zusammensetzung von Festkörpern, dünnen Schichten und Oberflächen
- Analyse von Grenzflächen zwischen Substraten und dünnen Schichten
- Elektronische und atomare Struktur von Oberflächen
|
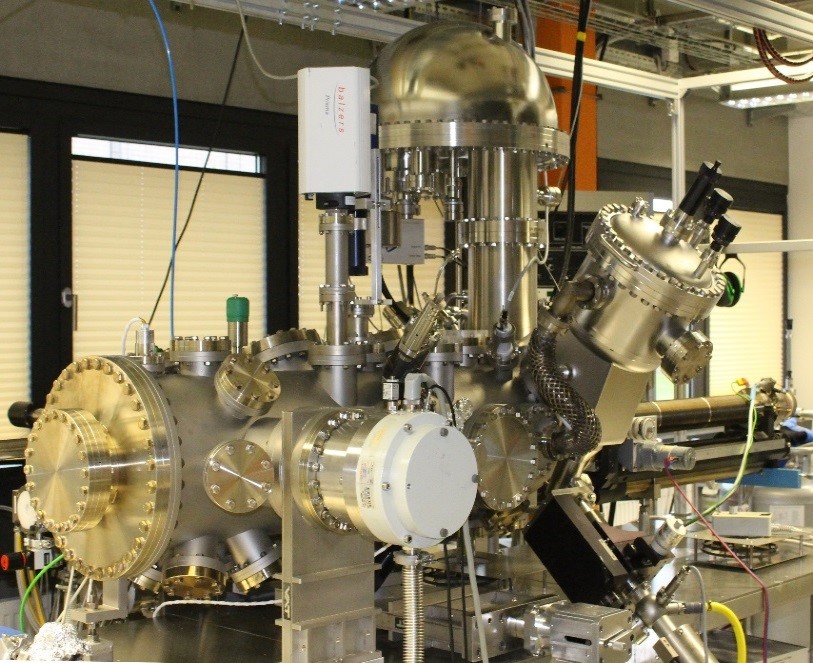 |
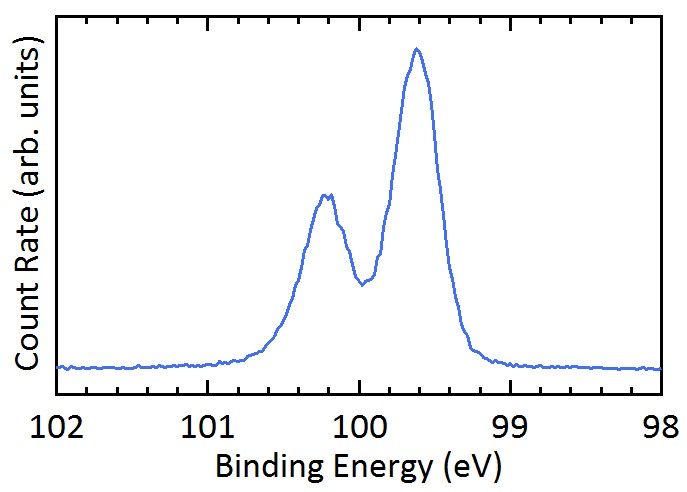
Si2p-Spektrum einer mit Wasserstoff terminierten Si(111)-Oberfläche. |
Spektrometer für winkelaufgelöste Photoelektronenspektroskopie (ARPES)
System bestehend aus einer Analysekammer mit
- Photoelektronenanalysator (Specs Phoibos 150 mit 2D-CCD-Detektor)
- Monochromatisierte Röntgenquelle (Specs Focus 500) für Al Kα und Ag Lα
- UV-Quelle (Specs UVS 300) mit Monochromator (Specs TMM 304) für linear polarisierte HeI- und HeII-Strahlung, Polarisation um 90° rotierbar
- 5-Achsen Probenmanipulator mit He-Kühlung bis ca. 20 K
und einer Präparationskammer mit
- Probenmanipulator mit Heizung bis ca. 1000 °C und Kühlung bis ca. 100 K
- Ar-Ionenquelle (Sputterkanone)
- LEED-Optik
- Ports für Verdampfer, etc.
Typische Anwendungen:
- Elektronische Bandstruktur von Festkörpern und Oberflächen
- Analyse chemischer Zusammensetzung von Festkörpern, dünnen Schichten und Oberflächen
- Analyse von Grenzflächen zwischen Substraten und dünnen Schichten
- Strukturelle Eigenschaften von Oberflächen
|
 |

Oberflächenzustand von Au(111).
(Monochrom. HeI, EPass =5 eV, TProbe=20K) |
Niederenergieelektronenmikroskop (LEEM)
System bestehend aus einer Analysenkammer mit
- Niederenergieelektronenmikroskop (Specs FE-LEEM P90)
- Hg-Lampe für PEEM
- UV-Quelle für PEEM
- Probenheizung bis ca. 1100 °C
und einer Präparationskammer mit
- Ar-Ionenquelle (Sputterkanone)
- Probenheizung bis ca. 1100 °C
Typische Anwendungen:
- Untersuchung von Schichtwachstum
- Strukturelle und elektronische Eigenschaften von Oberflächen und dünnen Schichten
|
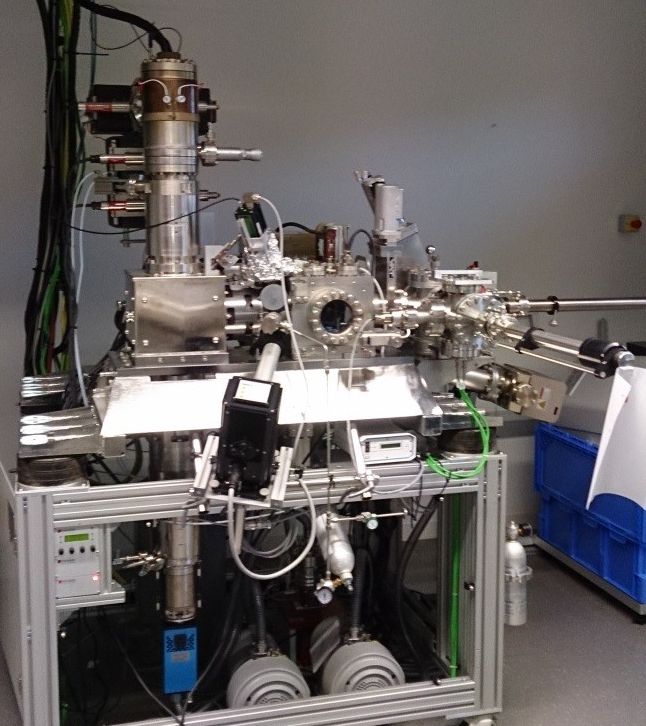 |

(a) LEEM Hellfeld-Aufnahme ELEEM = 2.6 eV) von Graphen auf 4H-SiC(1-100). (b) Typische Reflektivitätsspektren der Bereiche unterschiedlicher Schichtdicke. (c) Falschfarbenabbildung zur Darstellung der Schichtdickenverteilung. Aus M. Ostler et al., Phys. Rev. B 88 (2013) 085408. |
Rasterkraftmikroskop (AFM)
System bestehend aus
- Rasterkraftmikroskop (Park Systems XE100) unter Atmosphärenbedingungen mit optischem Mikroskop, motorisierter Probenaufnahme, separaten z- und x/y-Scannern
- Scanner für Bereiche von max. 5x5 µm2 und max. 100x100 µm2
- Akustischer Einhausung
- Aktiver Schwingungsdämpfung (Accurion)
Typ. Anwendungen:
- Untersuchung der Struktur und Morphologie von Oberflächen und dünnen Filmen
|
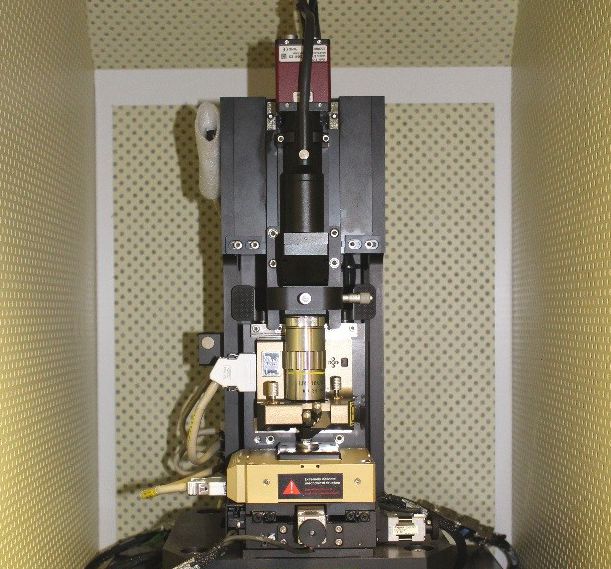 |
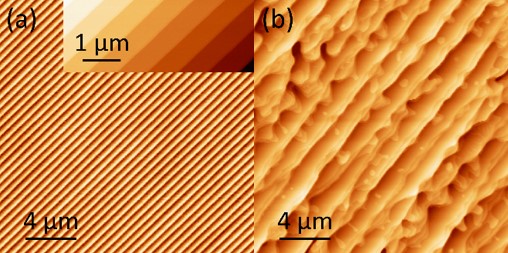
AFM-Bilder einer 6H-SiC(0001)-Oberfläche nach Ätzen in Wasserstoff (a) und nach darauffolgender Züchtung von Graphen (b). |
Profilometer
- Stylus Profilometer VEECO Dektak 8
Typ. Anwendungen:
- 2D- und 3D-Messung der Topographie von Oberflächen bis 200 mm Durchmesser
- Schichtdickenbestimmung
|
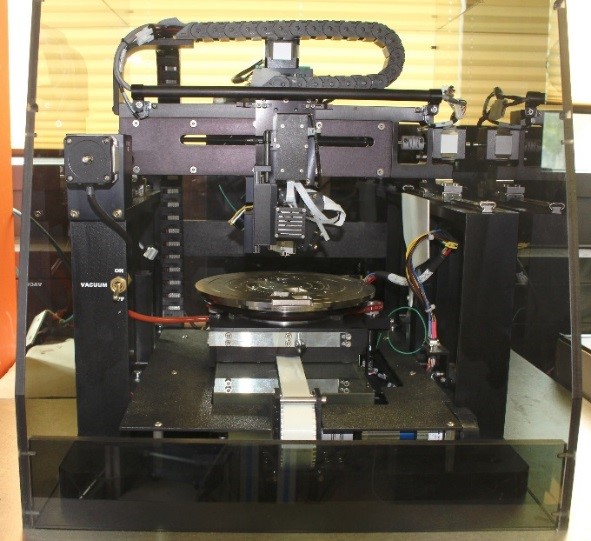 |

Zunahme der Schichtdicke von a-C:H Filmen, die bei verschiedenen Prozessdrücken zwischen 2 Pa und 8 Pa abgeschieden wurden, als Funktion der Anlasstemperatur. Aus S. Peter et al., Diamond and Relat. Mater. 45 (2014) 43. |