Vertikal-FET in oberflächennaher Si-Bulk-Mikromechanik
Sonderforschungsbereich 379 - Teilprojekt C5
Motivation
Ein wesentlicher Bestandteil mikromechanischer Systeme ist die Auswertung von Bewegungen für aktorische und sensorische Applikationen. Die mechanische Bewegung wird dabei mittels eines geeigneten Wandlerprinzips in ein elektrisches Signal umgeformt. Durch Weiterverarbeitung des elektrischen Signals können Rückschlüsse auf die ausgeführte mechanische Bewegung und deren Ursache gezogen werden.Die Wandlung der mechanischen Bewegung in ein elektrisches Signal erfolgt in der Mikrosystemtechnik überwiegend durch kapazitive Verfahren. Diese beruhen auf der Abstands- oder Flächenänderung einer Plattenkondensatoranordnung. Die resultierende Kapazitätsänderung wird über geeignete Verfahren, z.B. Relaxationsoszillator oder Strom-Spannungswandler etc., ausgewertet.
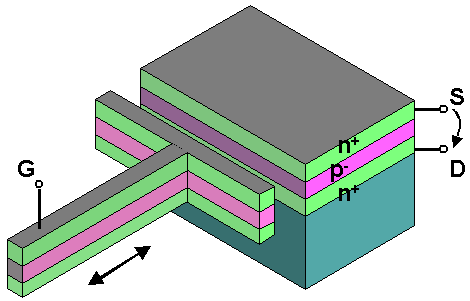 Ein Nachteil dieser kapazitiven Auswerteverfahren ist die Empfindlichkeit gegenüber Streu- und Leitungskapazitäten. Bei einem Nutzsignal von 5fF und einer Grundkapazität von 50pF ist eine Signalauswertung nur über entsprechend hochauflösende, rauscharme Verstärkerschaltungen möglich.
Ein Nachteil dieser kapazitiven Auswerteverfahren ist die Empfindlichkeit gegenüber Streu- und Leitungskapazitäten. Bei einem Nutzsignal von 5fF und einer Grundkapazität von 50pF ist eine Signalauswertung nur über entsprechend hochauflösende, rauscharme Verstärkerschaltungen möglich.
Inhalt des Teilprojektes "Vertikal-FET in Oberflächennaher Si-Bulk-Mikromechanik" ist die Entwicklung einer Technologie zur Herstellung einer mikromechanischen Schwingstruktur für laterale Bewegungen. Bei diesem neuen Verfahren wird der Feldsteuereffekt einer lateral beweglichen mikromechanischen Plattenanordnung auf eine vertikal dotierte npn-Schichtfolge ausgenutzt. Die npn-Schichtfolge bildet eine Drain-Source-Anordnung mit zwischenliegendem Kanalgebiet. Das über die bewegliche Plattenanordnung einwirkende elektrische Feld beinflußt die Ladungsträger und damit den Widerstand des Inversionskanals.
Im Unterschied zu einem konventionellen Feldeffekttransistor ist die veränderliche Größe nicht das Gatepotenzial sondern der Abstand der Plattenanordnung (Gateabstand) zum Kanalgebiet.
Aufbau des aktiven Sensors
Der Aktive Sensor besteht aus einem Massekörper, der an vier Federn aufgehängt ist. In der Strukturmitte befinden sich zwei Querträger, an deren Enden die Transistoren realisiert sind. Für eine exakte messtechnische Charakterisierung der Struktur sind an dem Massekörper Kammstrukturen angebracht. Mit diesen kann der Abstand zwischen dem beweglichen Teil der Struktur und der festen npn-Schichtfolge eingestellt werden.
Das Ausgangsmaterial für die npn-Schichtfolge war ein p--dotierter Wafer mit einer Konzentration von 5*1014 cm-3. In diesen wurde eine ca. 1,5µm dicke n+-Schicht implantiert. Danach erfolgte ein Aufwachsen einer p--Epitaxieschicht (ca. 10-12µm). Die oberen n+-Gebiete wurden durch eine As-Implantation realisiert.
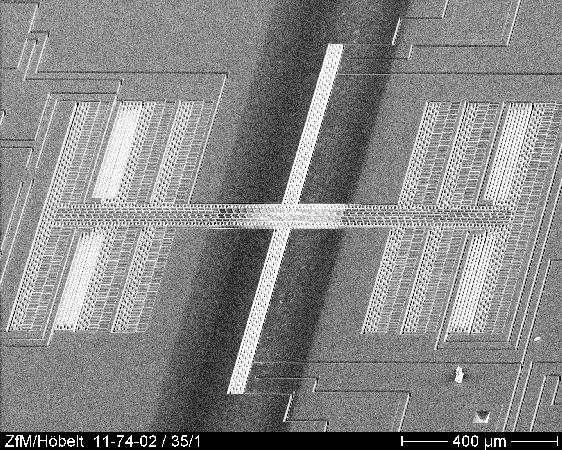
REM-Aufnahme des Vertikal-FET
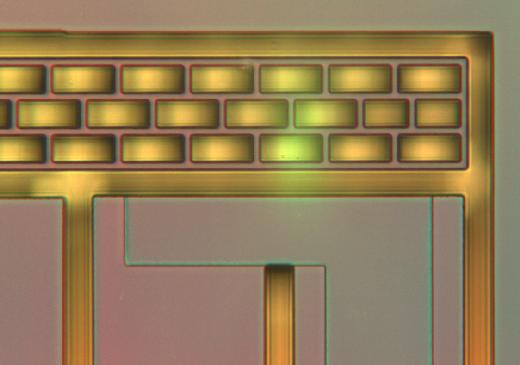
Lichtmikroskopische Aufnahme des Transistorbereiches
Vorteile gegenüber kapazitiven Verfahren
- Der Vertikal-FET benötigt bei gleichem Nutzsignal eine wesentlich kleinere Fläche.
- Die Wandlerstruktur bildet eine niederimpedante Signalquelle.
- Die Phasenlage der mechanischen Bewegung und des resultierenden Stroms sind gleich.
- Die Signalamplitude ist unabhängig von der Bewegungsfrequenz.
- Das Wandlerelement bildet einen aktiven Sensor.